Bei der Kathodenzerstäubung werden Ionen (meist Argon) auf ein Target beschleunigt und schlagen dort Atome oder Moleküle heraus, das Target besteht dabei aus dem Material der aufzubringenden Schicht. Die mittlere Weglänge dieser Teilchen ist wenige Millimeter lang, d.h. sie stoßen oft zusammen, dadurch werden auf der Scheibe auch vertikale Flächen gut bedeckt. Die abgeschiedenen Teilchen bilden eine poröse Schicht, die durch Temperung verdichtet werden kann. Die Kathodenzerstäubung lässt sich in das passive (inerte) und das reaktive Sputtern unterteilen.
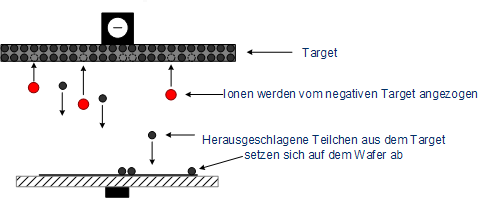
Beim passiven Sputtern wird nur das Material des Targets auf den Scheiben abgeschieden, entsprechend dem Material des Targets lassen sich hochreine Schichten erzeugen, da ein genaues Mischungsverhältnis der Stoffe im Target möglich ist. Beim reaktiven Sputtern wird dem Gas in der Prozesskammer ein Reaktionsgas (z.B. Sauerstoff O2) hinzugefügt, dass sich mit dem zerstäubten Material des Targets verbindet und sich dann auf dem Wafer absetzt. Dadurch lassen sich aus einem Metalltarget (z.B. Aluminium Al) auch Isolierungsschichten herstellen:
4 Al + 3 O2→2 Al2O3
Zur Erzeugung von metallischen Schichten wird das Gleichstrom-Sputtern (DC-Sputtern) verwendet. Dabei werden die Ionen mit bis zu 3 Kilovolt (kV) auf das Target beschleunigt und entladen sich dort. Da diese Ladungen immer abgeführt werden müssen, kann hier nur ein leitendes Material als Target dienen. Für isolierende Schichten muss das reaktive Sputtern eingesetzt werden. Will man eine isolierende Schicht direkt aus dem Target erzeugen, verwendet man das Hochfrequenzsputtern (RF-Sputtern).
Beim RF-Sputtern liegt die Spannung an je einer Elektrode hinter dem Target (Kathode) und dem Wafer (Anode) an. Durch die hochfrequente Spannung werden die Elektronen bei der positiven Halbwelle am Target von diesem angezogen, wodurch sich das Target negativ auflädt. Durch dieses negative Target werden die Ionen angezogen und schlagen dort Teilchen heraus. Beim Magnetronsputtern befinden sich zusätzlich Magnete hinter dem Target, so dass Elektronen auf Kreisbahnen abgelenkt werden und so häufiger Argonatome ionisieren können, was einen erheblichen Anstieg der Abscheiderate verursacht. Da die Anode mit der Prozesskammer verbunden ist, hat sie auf die Oberfläche bezogen im zeitlichen Mittel eine wesentlich geringere Potentialdifferenz gegenüber dem Plasma als die Kathode, weshalb die Ionen nur zum Target und nicht zum Wafer wandern.
Um die Kantenabdeckung zu erhöhen verwendet man das BIAS-Sputtern, bei dem am Substrat eine negative Spannung angelegt wird. Dadurch werden auch hier, wie am Target, Teilchen der erzeugten Schicht abgetragen und die Oberfläche eingeebnet. Jedoch muss darauf geachtet werden, dass kein Abtrag des Substrats erfolgt. Dieses so genannte Rückätzen ist auch das Prinzip der meisten Plasmaätzanlagen.
Schematische Darstellung einer Sputteranlage
Das Sputtern eignet sich somit zur Erzeugung von metallischen Schichten mit guter Konformität und sehr guter Reproduzierbarkeit. Der Aufwand ist gering, der Unterdruck mit 5 Pa recht einfach zu erzeugen.