1. Thermische Oxidation
Bei der thermischen Oxidation werden die Siliciumwafer bei ca. 1000 °C in einem Oxidationsofen oxidiert. Dieser Ofen besteht im Wesentlichen aus einem Quarzrohr in dem sich die Wafer auf einem Träger (Carrier) aus Quarzglas befinden, mehreren getrennt regelbaren Heizwicklungen und verschiedenen Gaszuleitungen. Das Quarzglas besitzt einen sehr hohen Schmelzpunkt (weit über 1500 °C) und ist deshalb sehr gut für Hochtemperaturprozesse geeignet. Damit es nicht zu Scheibenverzug oder Scheibensprüngen kommt, wird das Quarzrohr in sehr kleinen Schritten (max. 10 °C pro Minute) aufgeheizt. Die Temperierung ist mittels der getrennten Heizwicklungen im gesamten Rohr über eine Länge von ca. 1 m auf ± 0,5 °C exakt regelbar.
Darstellung eines Oxidationsofens
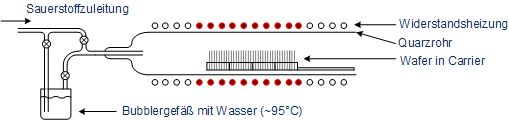
Der Sauerstoff strömt dann als Gas über die Wafer und reagiert an der Oberfläche zu Siliciumdioxid. Es entsteht eine glasartige Schicht mit amorpher Struktur. Je nach Prozessgas finden dann verschiedene Oxidationen statt, eine thermische Oxidation muss naturgemäß auf einer Siliciumoberfläche erfolgen. Die thermische Oxidation unterteilt sich in die trockene und feuchte Oxidation, welche sich wiederum in die nasse Oxidation und die H2-O2-Verbrennung gliedern lässt.
Trockene Oxidation
Der Oxidationsprozess findet unter reiner Sauerstoffatmosphäre statt. Dabei reagiert Silicium mit Oxid zu Siliciumdioxid:
Dieser Prozess findet in der Regel bei 1000–1200 °C statt. Zur Erzeugung von sehr stabilen und dünnen Oxiden wird die Oxidation bei ca. 800 °C durchgeführt.
Eigenschaften der Trockenoxidation
- langsames Oxidwachstum
- hohe Dichte
- hohe Durchbruchspannung (für elektrisch stark beanspruchte Oxide, z.B. Gateoxid)
Nasse Oxidation
Bei der nassen Oxidation wird der Sauerstoff durch ein Bubbler-Gefäß mit Wasser (ca. 95 °C) geleitet, so dass sich zusätzlich zum Sauerstoff auch Wasser in Form von Wasserdampf im Quarzrohr befindet. Daraus ergibt sich folgende Reaktionsgleichung:
Dieser Prozess findet bei 900–1000 °C statt. Er weist ein schnelles Oxidwachstum bei niedrigen Temperaturen auf und wird u. a. zur Herstellung von Maskierschichten und Feldoxiden verwendet. Die Qualität der erzeugten Schicht ist geringer als bei der Trockenoxidation.
Vergleich der Aufwachsrate bei trockener und nasser Oxidation
| Temperatur | Trockene Oxidation | Nasse Oxidation |
| 900 °C | 19 nm/h | 100 nm/h |
| 1000 °C | 50 nm/h | 400 nm/h |
| 1100 °C | 120 nm/h | 630 nm/h |
H2-O2-Verbrennung
Bei der H2-O2-Verbrennung wird neben hochreinem Sauerstoff auch hochreiner Wasserstoff verwendet. Die beiden Gase werden getrennt in das Quarzrohr geleitet und an der Eintrittsöffnung verbrannt. Damit es nicht zu einer Knallgasreaktion mit dem hochbrennbaren Wasserstoff kommt, muss die Temperatur über 500 °C liegen, die Gase reagieren dann in einer stillen Verbrennung. Dieses Verfahren ermöglicht die Erzeugung von schnell wachsenden und nur wenig verunreinigten Oxidschichten. Damit lassen sich sowohl dicke Oxide, als auch dünne Schichten bei vergleichsweise geringer Temperatur (900 °C) herstellen. Die niedrige Temperatur erlaubt auch die thermische Belastung von bereits dotierten Wafern (siehe Dotieren mittels Diffusion).
Bei allen thermischen Oxidationen ist das Oxidwachstum auf 111-orientierten Substraten höher als auf 100-orientierten (siehe der Einkristall). Außerdem erhöht ein sehr hoher Anteil an Dotierstoffen im Substrat das Wachstum deutlich.
Ablauf des Oxidationsvorgangs
Zu Beginn reagiert der Sauerstoff an der Waferoberfläche zu Siliciumdioxid. Nun befindet sich eine Oxidschicht auf dem Substrat durch die nachfolgende Sauerstoffatome zunächst diffundieren müssen, um mit dem Silicium reagieren zu können. Die Aufwachsrate hängt nur zu Beginn von der Reaktionszeit zwischen Silicium und Oxid ab; ab einer gewissen Dicke wird die Oxidationsgeschwindigkeit von der Diffusionsgeschwindigkeit des Oxids durch das aufgewachsene Siliciumdioxid bestimmt. Mit zunehmender Oxiddicke verlangsamt sich also das Wachstum. Da die entstandene Schicht amorph ist, sind nicht alle Bindungen der Siliciumatome intakt; es gibt teilweise freie Bindungen (freie Elektronen und Löcher) an der Si-SiO2-Grenzschicht. So ergibt sich an diesem Übergang insgesamt eine leicht positive Ladung. Da sich diese Ladung negativ auf Bauteile auswirken kann wird versucht, sie so gering wie möglich zu halten. Dies kann beispielsweise mit einer höheren Oxidationstemperatur erreicht werden, oder durch die Verwendung der nassen Oxidation, die ebenfalls nur eine sehr geringe Ladung verursacht.
Segregation
Bei der thermischen Oxidation wird Silicium durch die Reaktion mit Sauerstoff zu Siliciumdioxid verbraucht. Das Verhältnis der aufgewachsenen Oxidschicht zu verbrauchtem Silicium beträgt 2,27; d.h. das Oxid wächst zu 45 % der Oxiddicke in das Substrat ein.
Aufwachsverhalten von Oxid auf Silicium
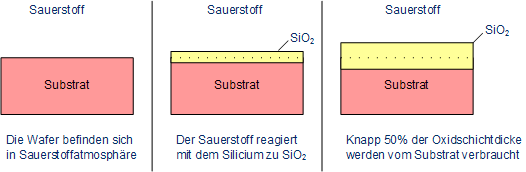
Dotierstoffe die sich im Substrat befinden, können im Siliciumkristall oder im Oxid eingebaut werden, dies hängt davon ab, in welchem Material sich der Dotierstoff besser löst. Dieser sogenannte Segregationskoeffizient k berechnet sich nach:
$$k=\frac{Löslichkeit\ des\ Dotierstoffs\ in\ Si}{Löslichkeit\ des\ Dotierstoffs\ in\ SiO_2}$$Ist k größer 1 werden die Dotierstoffe an der Oberfläche des Substrats eingebaut, bei k kleiner 1 reichern sich die Dotierstoffe im Oxid an.